台積電(TSMC)正經歷前所未有的人工智能(AI)芯片的需求,市場對英偉達的數據中心GPU的需求大幅度提高,為此不斷針對性地興建新設施,以滿足客戶的訂單需求。其中CoWoS封裝產能成為了瓶頸,為此台積電除了擴大產能外,還積極探索新的封裝技術。
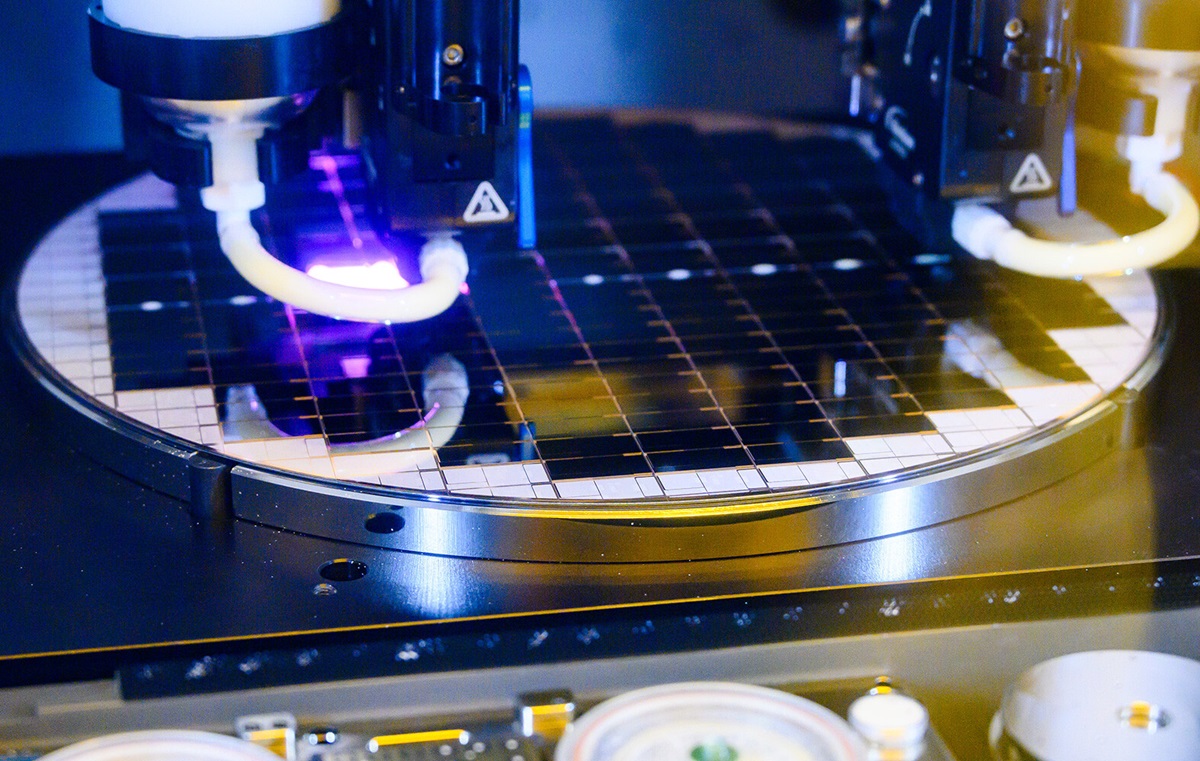
據相關媒體報導,近日有業內人士透露,台積電正在開發一種新的先進芯片封裝技術,將使用矩形基板,而不是傳統的圓形晶圓。其允許將更多芯片放置在單個基板上,從而滿足未來人工智能芯片的製造需求。雖然研究還處於早期階段,可能還要等幾年時間才能量產,但代表了台積電重大技術轉變,再一次站在芯片製造技術的前沿。
據了解,台積電正在測試的矩形基板尺寸為515mm x 510 mm,與目前12英寸(300mm)晶圓相比,可用面積是其3.7倍以上,可以更好地滿足市場對芯片的需求。使用矩形基板還可以更好地消除圓形晶圓邊緣上不完整的芯片,雖然聽起來只是使用的晶圓形狀發生了改變,但實際上要對整個製造流程進行徹底改造。
台積電也迴應了媒體的報導,表示正在密切關注先進封裝技術的進步和發展,包括面板級封裝技術。